
塑封是广泛应用的5G电子封装技术之一。其封装的基板和塑封料主要成分是树脂,具有亲水性和多孔性。当水分进入封装中,会使得塑封的电子元器件发生由于吸湿引起的界面层破裂和电子元器件的整体失效破坏,甚至发生“爆米花”式的断裂。所以如美国空军航空电子完整性项目发现的,湿度也是引起电子产品失效的重要因素。
对吸湿分析而言,最主要是依据湿度的扩散机理,获取封装中湿度分布,最后分析湿度应力。采用菲克第二定律(Fick’s second law)来预测随着时间变化,扩散对浓度分布的影响:

同时为了求解湿度应力,需要热-结构-扩散直接耦合单元22X系列求解计算。通过以上湿度扩散和耦合单元,可以获得封装结构湿度分布和湿应力状态,用于找出封装结构薄弱区域。参考GB2423.3-93等行业标准,可以对封装在湿度环境下进行试验:
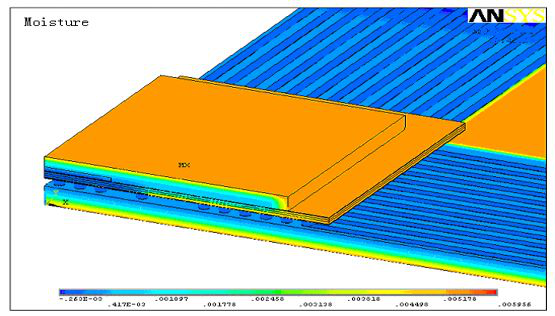
封装中湿度浓度分布
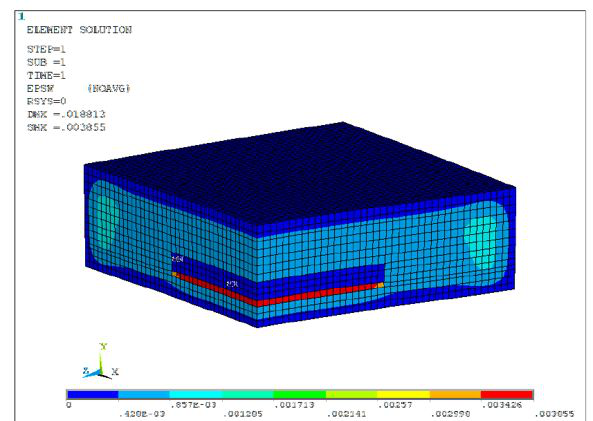
封装中湿应力引起的应变
本篇我们先对PCB/封装在潮湿环境下吸湿膨胀(爆米花效应)进行了讨论,欢迎和瑞凯仪器继续探讨5G设备可靠性试验相关技术问题。


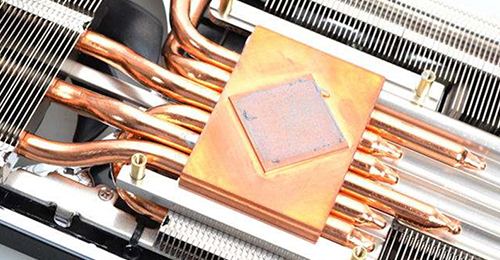

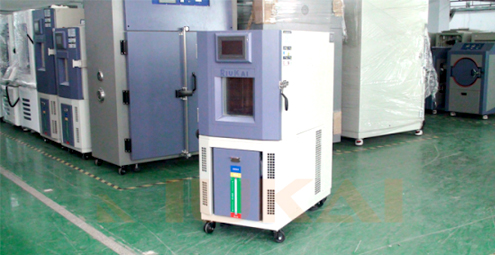



 客服微信
客服微信